非对称功率偏置对关键等离子体半导体工艺
叶戈尔·Y·萨莫伊连科 , 博士, 高级工程师, 先进能源工业公司, 科罗拉多州弗莱森斯
托马斯·G·詹金斯 , 博士, 高级科学家, Tech-X 公司, 科罗拉多州博尔德
丹尼斯·M·肖 , 博士, 技术院士, 先进能源工业公司, 科罗拉多州弗莱森斯
半导体芯片制造中的许多关键步骤使用电离气体(等离子体)来构建构成微电子电路的复杂电路层。等离子体既用于添加材料(“沉积”)也用于去除材料(“蚀刻”)。所需结果取决于所使用的气体,但大多数等离子体设备配置为施加电力以实现两个关键目标:等离子体化学控制和对晶圆表面的离子轰击。
提供几百 kHz 到几十 MHz 范围内正弦波形的射频(RF)电源传统上被用来控制两个目标。虽然正弦波形并不是为了优化工程师试图优化的各种等离子体参数而特别开发的,但它们足以适用于广泛的等离子体蚀刻和沉积工艺,并且历史上一直支持着摩尔定律的扩展。
随着半导体行业向越来越小的尺寸发展,现在接近原子尺度,并且使用更多材料的更复杂的 3D 结构,工程师们正接近传统等离子体处理能力的极限。 图 1 对微电子制造的宏观趋势以及相应技术挑战进行了分类。

图 1. 微电子制造的趋势和挑战。
要形成半导体器件电路层,在等离子体辅助工艺中需要精确控制离子到达晶圆表面的情况。传统的正弦波形功率会产生撞击晶圆表面的离子宽能量分布。这是一个正弦波形技术的例子,它最初是为其他应用开发的,为晶圆处理提供了“足够好”的结果。
在过去十年中,Advanced Energy 开创了一种不同的方法来选择施加到等离子体离子以到达晶圆表面的波形。而不是继续优化越来越受影响的正弦射频频率解决方案以实现所需的离子能量控制,工程师们采用了一种基于第一原理的方法来确定哪种波形能够产生精确的离子能量分布,以实现 最佳 刻蚀结果。他们继续询问如何在整个等离子体处理设备遇到的宽泛的等离子体条件下实现这一点。回答这些问题导致了一种独特的非对称波形 [2] 的设计,旨在为等离子体工艺工程师提供“旋钮”来直接控制离子能量分布 (IED)。这项技术被整合到 eVoS® 偏置电源平台中,该平台提供对晶圆表面电压和离子能量分布的直接控制。
从原子层刻蚀和沉积到高纵横比特征,精确的离子能量控制使新一代的等离子体工艺成为可能。
RF 偏置是如何工作的?
等离子体加工工具通常配置有两个或多个电源,如图<强 id=0>图 2 所示。等离子体在称为等离子体腔室的反应器中产生,该反应器能够抽真空(亚大气压)并填充用于产生等离子体的各种气体。
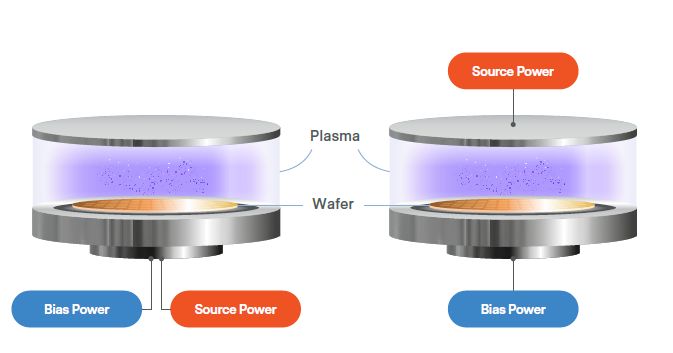
图2。典型等离子体加工腔室的简单示意图。源功率和偏置功率可以合并并通过晶圆支架(左侧)馈送到等离子体,或者通过源功率和偏置功率馈送到等离子体腔室(右侧)。
一个电源,通常称为“源功率”,用于点燃和维持等离子体。该电源产生化学活性气体种类和电性带电种类(电子和离子),这些构成了加工等离子体的主体。另一个电源(或多个电源)用于将电能施加到工件上,在半导体制造行业中,工件通常是硅晶圆。该电源的任务是控制离开等离子体并撞击晶圆表面的正电离子的能量,通常称为“偏置功率”。
由于等离子体腔体组件和待加工晶圆都具有电绝缘特性,因此需要交流(AC)电源,通常在 100 kHz 至 10 MHz 的射频范围内振荡,以将电能从电源通过晶圆电极传递到等离子体。施加到晶圆电极的电源的主要目的是加速离开等离子体的离子,使其到达晶圆表面以在晶圆表面进行工作。施加的偏置功率在等离子体和晶圆电极表面之间形成一个区域,称为鞘层,该鞘层支持一个电场,将带电离子加速到晶圆表面。这些离子撞击晶圆表面时具有的能量范围称为离子能量分布(IED)。当交流/射频电源驱动偏置晶圆电极时,鞘层之间的电势在施加的频率下随时间振荡。因此,离子穿过鞘层时获得的能量取决于离子进入鞘层时鞘层的电势。 一个交流波形在“顶部”和“底部”停留的时间比它在“顶部”和“底部”之间转换时的时间更长。

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码