手机芯片UV胶绑定可靠性分析
时间:2009-07-23来源:网络
A2板切片后,主芯片焊点U1在PCB侧焊盘处出现局部开裂现象,如图5所示。

B1板切片后,主芯片焊点A17在PCB焊盘下方有开裂现象,如图6所示。
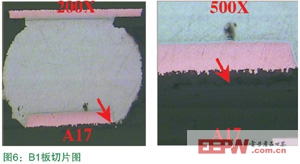
B2板切片后,主芯片焊点U17在PCB焊盘与锡球之间有开裂现象,如图7所示。
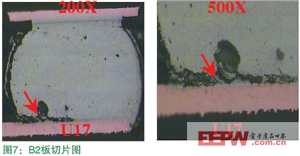
C1板切片后,主芯片焊点U1在PCB焊盘和锡球之间有开裂现象,如图8所示。
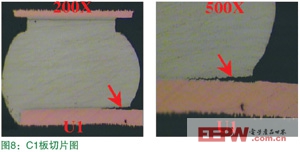
C1板切片后,主芯片焊点U1在PCB焊盘和锡球之间有开裂现象,如图8所示。
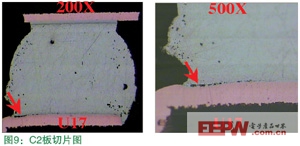
返修工艺对比
对底部填充和UV胶绑定工艺手机主板的返修情况及工艺成本进行比较(见表2),UV胶绑定芯片返修容易且没有报废。


加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码