SiC FET的起源及其向着完美开关发展的历程
使用宽带隙半导体作为高频开关为实现更高的功率转换效率提供了有力支持。一个示例是,碳化硅开关可以实施为SiC MOSFET或以共源共栅结构实施为SiC FET。本白皮书追溯了SiC FET的起源和发展,直至最新一代产品,并将其性能与替代技术进行了比较。
白皮书
当然,接近完美的电子开关已经存在很长一段时间了,但是我们这里要谈的不是机械开关。现代功率转换依赖的是半导体开关,它们最好在打开时没有电阻,在关闭时电阻和耐受电压无限大,并能在简单驱动下以任意快的速度在开关状态间切换且没有瞬时功率损耗。
在这个重视能源与成本的世界中,这些特征可以让电源、逆变器、电池充电器、电机驱动等器件实现更高的功率转换效率。随之而来的好处是设备体积、重量和故障率的下降,而且采购成本和生命周期成本也会降低。有时候,仅仅突破一个效率阈值就能打开一个全新的应用领域。例如,如果电机驱动极为耗能,并因此又大又重,从而需要更多电池电量,这又意味着重量提升和单次充电行驶里程缩短,那么电动车将难以实现。从近75年前的肖克利、巴丁和布拉顿时代起,工程师们就不断努力改进半导体开关,使其趋近于理想开关。
向着理想开关前进的历程
实际上,首个功率转换应用中使用的是机械开关,机械“振动器”一开始是绝缘直流转换或直流电源升压装置的电动发电机的唯一选择。然而,大约在晶体管发明十年后,首个“开关模式”的电源(SMPS)出现了,从那时起,设计师就必须处理可用的半导体技术了。虽然1930年Julius Edgar Lilienfeld就提出了场效应晶体管(FET)原理并取得了专利,但是当时无法制造FET。最初采用锗的双极型晶体管占领了早期的SMPS电路领域。
起初,双极型晶体管的额定电压有限,在关态下漏电大,开关过程缓慢且损耗大,且基极驱动复杂。现在,功率双极晶体管增益低,可能需要放大基极电流。基极中存储的电荷是一个大问题,限制了关闭时间和效率,因此还要采用技术来精确定制基极驱动并且采用“贝卡钳位”等技术来限制电荷,这种技术会以带来一定的导电损耗为代价实现较低的动态损耗。
在70年代和80年代,硅 MOSFET可以用于大功率,当时采用的是垂直导电路径和平面栅型结构,在90年代变为采用“沟槽”结构。然而,可实现的额定电压和导通电阻限制了在更高功率下的使用。70年代晚期有了重大进步,出现了绝缘栅双极晶体管(IGBT),它将类似MOSFET的栅极驱动与类似双极的导电路径相结合,实现了轻松栅极驱动和固定饱和电压的优势,因而MOSFET中的名义功耗的增加会与电流而非电流平方成正比。然而,IGBT也有自己的问题,它有闩住的倾向,这会造成灾难性后果。关闭时的“尾电流”也会带来相对较高的动态损耗,并限制运行频率。在现代IGBT中,闩住问题现已得到解决,尾电流也已尽量降低,同时额定电流和电压大幅提高,因而在非常高的功率转换中也常常应用这些器件。不过,由于动态损耗,开关频率仍被限制在最高数十kHz。
高开关频率是实现更小的磁性元件以及整体更小更轻并有更高性能控制回路的功率转换产品的关键,因此,随着MOSFET导通电阻和额定电压的提高,它们得到了越来越广的应用,频率也提高到了数百kHz,“超结”类型成为前沿技术。不过,硅的击穿电压是一个限制因素,使得在给定运行电压及其导致的高导通电阻(RDS)值下,块体材料要达到一个最小厚度。将许多单元并联可以降低该值,但是会提高总晶粒面积。该效应可以通过单位面积导通电阻这个“品质因数”(也就是RDSA)来量化,它促使人们对于宽带隙材料碳化硅(SiC)和氮化镓(GaN)的兴趣激增,这二者的固有击穿电压较高,并具有电子迁移率较高、饱和速度较高、承温能力高等有利特点,SiC还具有较好的导热系数。图1显示的是硅、SiC和GaN材料的标志性特征的比较。
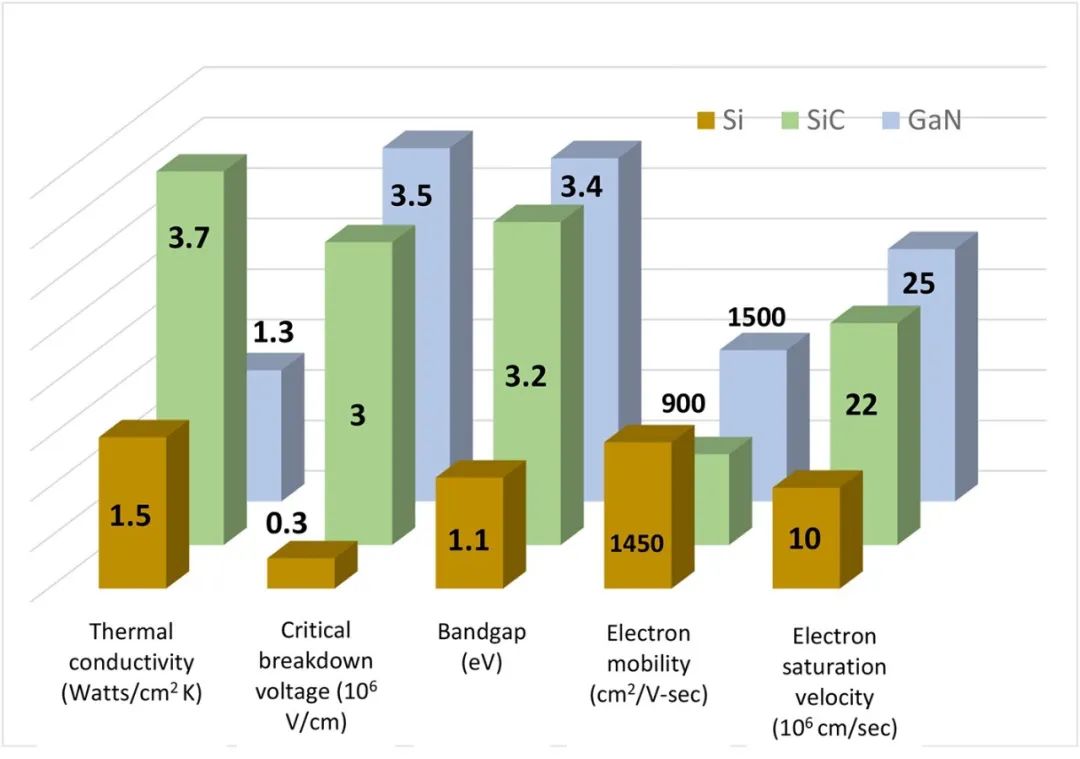
【图1. Si、SiC和GaN材料的特征】
SiC器件的早期发展
SiC器件的发展比GaN早十年,最初预计具有更广泛的适用性,可用于更高的额定电压和功率。SiC开关的一个自然起点是考虑开发增强型常关MOSFET,以实现与现有Si MOSFET设计和制造技术的兼容。与所有新技术一样,初期存在困难,有些困难可以预测,有些不可以,这些困难延迟了器件的商业化进程。
SiC过去和现在都存在的一个固有特性是晶格缺陷的数量比硅大,这会导致与SiC沟道的栅氧化层接面处的电子迁移率低,进而导致导通电阻相对较高。为了成本效益,SiC晶圆的体积必须尽可能大,而在6英寸行业标准下很难维持低缺陷率和晶圆平面度。SiC MOSFET还表现出了栅极阈值不稳定性并伴有显著迟滞,从而使栅极驱动设计难以实现优秀的效率和可靠性。虽然最新的SiC MOSFET有所改善,而且理论上可以使用单极0-15V驱动,但是在实际中,通常使用-5V栅极驱动电压实现可靠运行。15V也不能实现非常低的导通电阻,因此通常使用18V实现最佳效率,而代价是降低短路耐受能力,且距离通常为19或20V的最大绝对值的裕度下降。已经解决的其他问题有短路和过压事件后栅氧化层降级,以及由于器件闭锁状态下漏栅场强度高导致的栅氧化层电场应力过大。
2010年左右,使用SiC MOSFET还遇到了没有预料到的困难,基底面位错,也就是晶格中的大块缺陷,事实上缺陷会在运行应力的作用下变大和移动。体二极管会从源极导电到漏极,因此会生成电子空穴载体,当电子空穴载体重组时,它们会有足够的能量移动和放大缺陷。这是SiC的较高带隙能量值导致的结果,且可能会导致降级,即产生较高的漏电流和导通电阻,而这又会导致较高的损耗和故障。当今的SiC MOSFET已经有了大幅改进,制造方法和缺陷筛查也有了进步,但仍需努力提高晶粒的产量和成本效益、封装的性能,以实现低电感和低热阻。
备用方法SiC FET
宽带隙技术诞生后,虽然许多半导体制造商采取了使用现有生产线开发SiC MOSFET的路线,但是还有一些从“白纸”开始,考虑其他选择。采用SiC实施的最简单的开关是JFET结构开关,它没有栅氧化层,是单极导电器件,因此不存在MOSFET的一些限制。不过该器件存在一个重大缺陷,它是常开型器件,栅极驱动电压为零,需要负的驱动电压才能关闭。这无论如何都不方便,在最坏的情况下会导致应用故障风险,尤其是在系统打开/关闭等瞬态情况下。SiC FET解决了该问题,它最初是在90年代提出的,在2010年前后开发出来。它将SiC JFET与常关型的硅MOSFET结合,保留了JFET相对MOSFET的优势。图2比较了SiC FET结构(右)与一般SiC MOSFET示意图(左)。
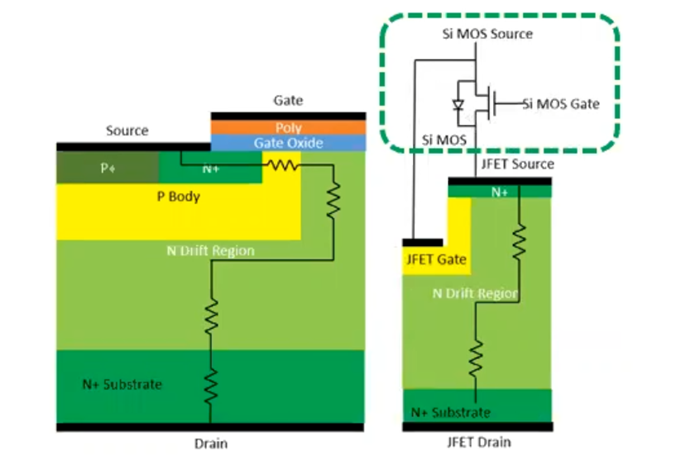
【图2. SiC MOSFET(左)与SiC FET(右)的构造】
SiC FET采用共源共栅结构。较为成熟的设计师可能会熟悉这种结构,他们见过这种结构最初的实施形式,即旨在降低音频放大器内噪音的电子管组合。多年来,已经有了多种形式的共源共栅或“发射极开关”,它们将双极型晶体管或BJT与MOSFET结合,具有低压开关控制高压开关的一般属性,并在高额定电压与轻松驱动之间达成了良好平衡。然而,由于显著的基极驱动电流必要性和缓慢的开关速度,采用BJT的电路并不受高压应用的青睐。SiC共源共栅,即“SiC FET”解决了这些问题。
从图3显示的SiC FET示意图中可见,当Si-MOSFET通过栅极打开时,JFET源极和栅极会有效短接,然后JFET会导电。此时,电流可以经过JFET和MOSFET漏源沟道,并由JFET修正导电损耗,因为与高压SiC JFET相比,低压Si-MOSFET导通电阻可能非常低。当Si-MOSFET关闭时,JFET源极电压升高至某个点,使得栅源电压超过负几伏的阈值,然后JFET关闭。由于器件电容比,跨Si-MOSFET的电压会动态维持在低位。
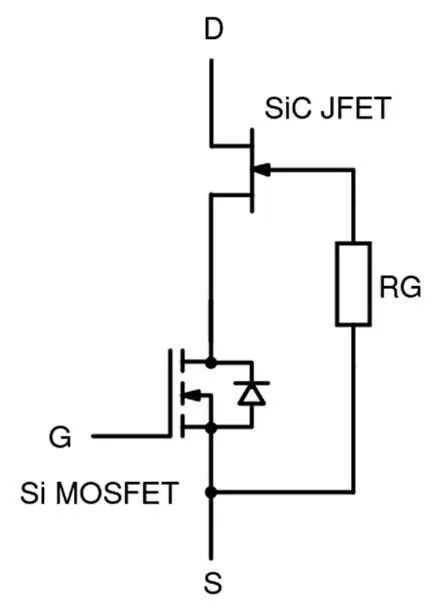
【图3. SiC FET示意图】
与SiC MOSFET相比,SiC FET在电气性能和实际使用中都有许多优势。作为开关,导通电阻是一个重要因素,而SiC JFET固有的沟道内电子迁移率比SiC MOSFET好得多,沟道密度也较高。这二者的结合意味着在给定晶粒面积下,SiC FET的导通电阻是SiC MOSFET的四分之一至二分之一,或者反过来,在导通电阻相同时,每个晶圆产出的晶粒最多可以达到后者的四倍。与硅超结MOSFET相比,增加的晶粒数最多可以达到13倍。鉴于碳化硅这种材料很可能一直都会比硅贵,每个晶圆产出的碎晶粒数的增加对于SiC FET技术的成功至关重要。正如上文讨论的,晶粒可行性的衡量指标是品质因数RDSA。
表1中显示的另一个品质因数是RDS*EOSS,也即导通电阻和器件输出开关能量之间的权衡,输出开关能量是输出电容带来的。这个指标很有用,它表明可以通过在晶粒中并联更多单元来降低导通电阻和导电损耗,但除了增加面积,这还会直接提高电容进而导致EOSS提高,结果是增加由频率决定的开关损耗。因此,RDS*EOSS值低是有利的。
SiC FET的栅极就是共源共栅结构中的Si MOSFET的栅极。它的阈值约为5V,稳定,基本无迟滞,因此能以12V或15V轻松驱动,实现全面增强和低RDSON,且距离通常的25V绝对最大值有很大的裕度。名义上,轻松的SiC FET栅极驱动兼容硅MOSFET电平,甚至是IGBT电平,从而让现有产品设计升级可以实现反向兼容。在实践中,SiC MOSFET单元需要定制驱动结构以实现最佳效率和足够的栅极过压保护,GaN HEMT单元无疑也是如此。
由于器件尺寸小以及共源共栅结构中Si MOSFET的绝缘效应,SiC FET几乎没有栅漏或“米勒”电容Crss,因而能实现极快的开关。输出电容COSS以及相关的开关能量EOSS都低,如表1所述,这还会导致快速开关和非常小的损耗。边缘速率也很快,以至于在实际电路中,SiC FET必须放缓,以限制电压过冲和电磁干扰。这可以通过添加栅极电阻实现,但是可能会导致在高开关频率下出现无法接受的控制延迟,因此简单的RC缓冲电路常常是较好解决方案。由于通常采用电容是COSS 3倍左右的电容器,串联电阻中的耗散非常小。图4显示了常见SiC FET器件电容及其漏极电压处于闭锁状态的变种。Ciss = CGS + CGD,(CDS短接),Crss = CGD,Coss = CDS + CGD。
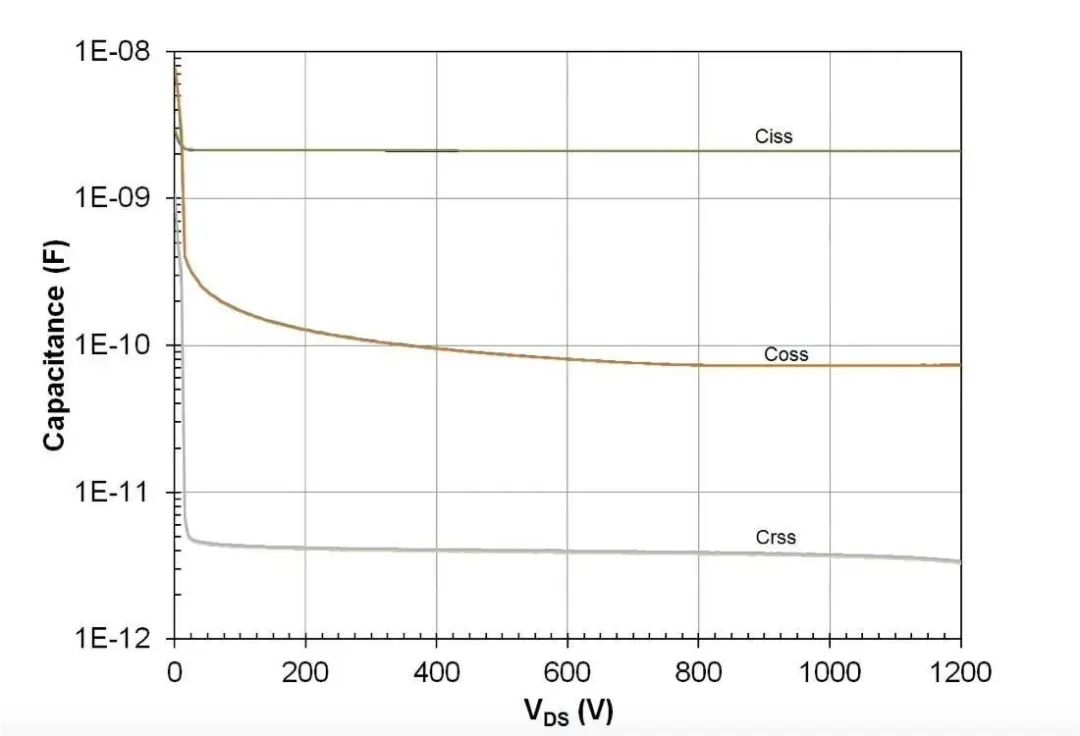
【图4. SiC FET器件电容】
SiC FET“体二极管”
在功率转换器中,完美开关应该能以低损耗向两个方向导电。交流电动机和有电感负载的转换器等电路中也确实有这样的要求,称为“第三象限”运行。IGBT无法满足此要求,并且需要并联二极管,而以硅和SiC为材料的MOSFET和JFET可以在栅极的控制下通过沟道向正反任何一个方向导电。MOSFET还有JFET所缺少的固有体二极管,在器件沟道通过栅极打开以允许反向电流前的“死区时间”内,该体二极管通过在有电感负载的硬开关转换器中“换向”来自动导电。此导电会存储电荷Qrr,在体二极管随后反向偏压时又会恢复该电荷,而此操作会带来显著的功率耗散峰值,随着频率增加,该峰值让平均值越来越高,从而降低了效率。采用硅MOSFET时,该效应非常严重,以至于它们实际上无法用于在连续导电模式(CCM)下运行的广受欢迎的图腾柱PFC级等部分电路。SiC MOSFET的Qrr值比硅好十倍,但是还是SiC FET比较好,因为SiC FET的器件输出电容较低且低压MOSFET中存储的电荷极小。比较结果因器件的电压等级而异,但是图5显示的是SiC FET和类似的硅超结MOSFET的典型反向恢复图。
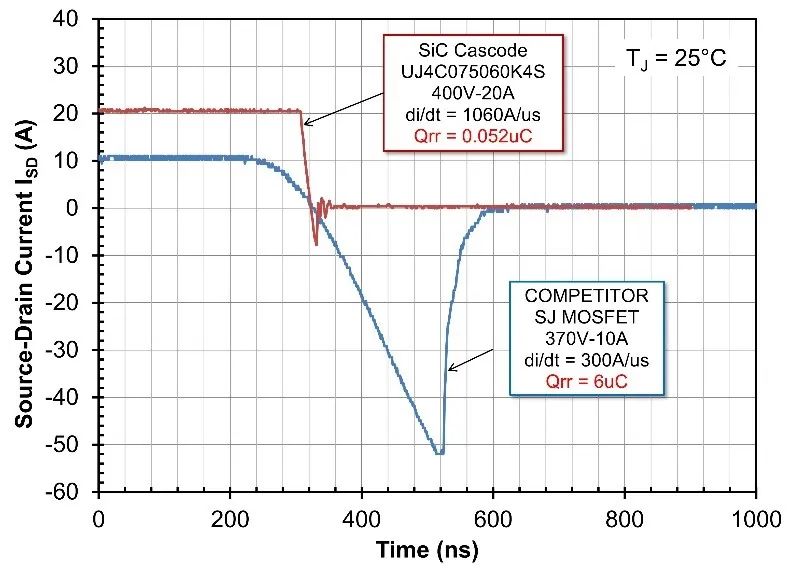
【图5. SiC FET共源共栅的反向恢复电荷是硅超结MOSFET的一百分之一】
虽然SiC MOSFET和GaN器件的反向恢复损耗足够低或者根本没有,但是反向导电的压降是另外一回事。这可能在死区时间内在功率转换器中造成显著损耗。硅超结MOSFET会带来通常为1V左右的二极管压降,而SiC MOSFET则差很多,体二极管的压降会轻松达到4V。在第三象限运行中,GaN HEMT单元的压降Vsd是I*R沟道电压与栅极阈值电压减去栅源电压之和,即Vsd = (Vth-Vgs)+(Isd*Ron)。
GaN的栅极阈值通常为1.5V,因此在大电流下,总压降可能会很高。如果栅极驱动电压为负以实现关闭,这很常见,则此电压Vgs会增加到源漏压降中,导致若干伏的Vsd,这比其他技术差很多。在从源极导电到漏极的过程中,SiC FET的沟道电阻会产生I*R压降,类似于GaN器件,但是压降增加值仅为跨共源共栅的低压Si MOSFET的体二极管的电压,该值相对较低。最终的正向电压通常约为1.5V,比SiC MOSFET或GaN强。
证明SiC FET的可靠性
宽带隙开关很坚固,尤其是因为它有固有高承温和高击穿电压能力,SiC FET的一个特别优势是没有SiC MOSFET中存在的SiC栅氧化层,该栅氧化层存在因高电场而降级的问题。共源共栅结构中的Si-MOSFET是一种坚固的低压器件,有高阈值电压和厚栅氧化层,还受到内置稳压钳位电路的保护。在实际应用中,SiC FET表现得非常可靠,其器件现在通常都能达到汽车AEC-Q额定值。还有一个重要考虑事项是在意外应力事件中的稳定性,如在过压和短路事件中。SiC FET有非常强大的雪崩能力,这是通过JFET漏栅击穿实现的。通过图3中Rg的最终电流会让电压降低,从而打开JFET并限制过压。Si MOSFET现在会雪崩,但是其雪崩高度可控,因为在每个单元的制造中都包括了雪崩保护二极管,且雪崩耗散的功率很少。SiC MOSFET还有雪崩额定值,但是GaN HEMT单元没有,这使得制造商将器件的额定电压定得较低,以便在运行电压和破坏性的击穿电压之间留出充足的裕度。
SiC FET还具备良好的短路电流特征,在大电流下,跨沟道的压降梯度会造成自然“夹止”效应,以限制电流。短路电流不受栅极电压影响,这与MOSFET和IGBT不同,而SiC FET沟道的导通电阻正温度系数还有助于降低极限电流和跨晶粒的各个单元传播应力。该效应始终如一,以至于SiC FET可用作线性电路中的精确限流器件。汽车应用中的一个典型测试是让器件经受短路电流至少5µs,而图6表明750V SiC FET可经受应力8µs而不降级。图7显示的是在采用1200V额定值的SiC FET时,导通电阻随温度上升,从而将短路电流降低到最终值的效应,这基本不受初始结温影响。
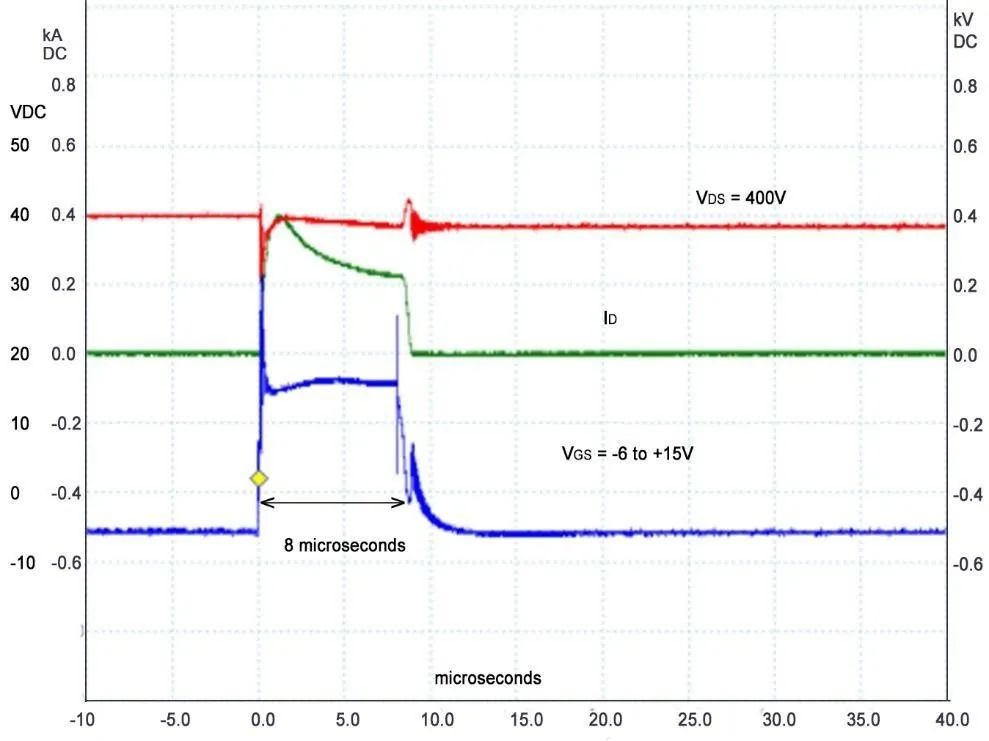
【图6. SiC FET经受来自400V总线的短路应力8µs】
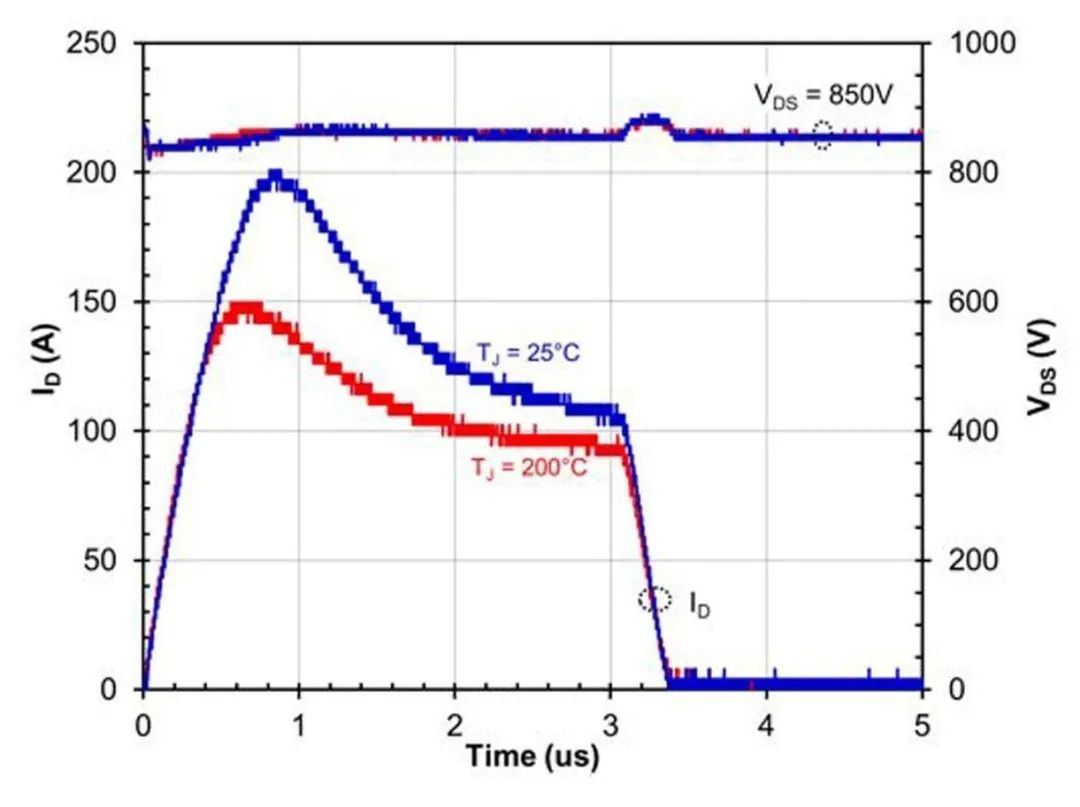
【图7. SiC FET短路电流不受初始结温影响】
为了维持可靠性,应该尽量减小封装中的SiC FET的温度上升和梯度,而在这里,SiC的导热系数是硅或GaN的3倍以上是一项优势。最新器件还使用银烧结技术进行晶粒连接,而非焊接,这将接面的导热系数提高到了6倍,从而维持了低结温和高可靠性。

其他SiC FET应用
SiC FET天然适用于高效功率转换器,最高额定值为1700V,可用于典型的工业三相应用。然而,通过在起控制作用的Si MOSFET上“堆叠”SiC JFET可轻松推广共源共栅原理(图8)。现已采用该原理开发出了额定值为40kV的模块。

【图8. 堆叠式共源共栅原理可用于额定值高达数十千伏的高压中】
如上所述,SiC JFET具有饱和电流几乎不随栅源和漏极电压而变的特性,这在电路保护应用中是一个优势,例如限流器或断路器。图9显示的是使用SiC FET共源共栅结构的自偏压断路器概念,这是一个真正的“双端子”结构,没有外部辅助电源轨和内部直流转换器。

【图9. 双端子自偏压断路器概念】
性能和值的改善历程
SiC FET随着一代代技术的发展而进步,“第四代”是最新一代技术,取得了许多进步,包括可用的电压范围、能获得更好的导通电阻的单元密度和能改进热性能的烧结式晶粒连接方式。现已采用“基质减薄”技术,因为沟道电阻非常低,以至于通过基质本身的导电损耗也变成一个限制因素。器件也在不断改进,尤其是降低了输出电容COSS。这能减少硬开关拓扑中的损耗,例如连续导电模式中图腾柱PFC,还支持软开关谐振电路提高运行频率,如LLC或PSFB电路。现在的开关边缘速率非常快,以至于器件分为“超快”和故意降速的“快速”两种,以用于边缘速率对性能不很重要但是会导致电磁干扰和击穿问题的应用,如电机驱动。
与第一代SiC FET相比,封装也有所进步,第一代将Si MOSFET和SiC FET晶粒并排布置,并以丝焊连接。这种进步带来了灵活性,例如采用TO-247封装,但是为实现更低的成本和更高的性能,现在常见的是“堆叠的”晶粒布置,可用较大的晶粒实现大电流,尤其是当在小巧的模块中并联器件时。焊接式晶粒连接方法已经被银烧结取代,以实现更好的热性能。TO-220、TO-247和D2PAK封装仍广受欢迎,因为它们支持改造SiC FET使其适合较早的设计,甚至是使用IGBT的设计。这些封装的四引脚版本采用“开尔文”源极连接,可缓解源极引脚电感干扰栅极驱动回路所造成的问题。
除此之外,由于其电气性能,SiC FET的采用价值在不断升高,同时,由于不断提升产量和向8英寸晶圆发展,SiC FET还拥有了降低成本的方案。
SiC FET是引人瞩目的解决方案
随着最新一代SiC FET的诞生,我们现在又向着理想开关迈进了一步。导电损耗和动态损耗变得前所未有的低,使得高频功率转换级的能效达到99%+,并伴随相应的能量节省、体积减小和重量减轻。设计师定义的“理想”则包含更多含义,他们还希望器件能轻松驱动,采用方便的封装,有稳定特性,在各种运行条件和故障状态下运行。与此同时,设备最终用户则希望最终产品可靠,整个生命周期的成本比较早的技术实施有实质性进步。UnitedSiC提供的SiC FET实现了他们的愿望,该系列器件的额定电压从650V到1700V不等,导通电阻降低至7毫欧。UnitedSiC还提供了 FET JET calculator作为设计辅助工具,方便快速为一系列功率转换拓扑选择器件和预测任何器件在这些拓扑中的性能,包括PFC级拓扑和绝缘/非绝缘的直流转换器拓扑。

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码
