用于电源SiP的半桥MOSFET集成方案研究
编者按:系统级封装(System in Package,SiP)设计理念是实现电源小型化的有效方法之一。然而,SiP空间有限,功率开关MOSFET的集成封装方案对电源性能影响大。本文讨论同步开关电源拓扑中的半桥MOSFET的不同布局方法,包括基板表面平铺、腔体设计、3D堆叠等;以及不同的电源互连方式,包括键合、铜片夹扣等。从封装尺寸、载流能力、热阻、工艺复杂度、组装维修等方面,对比了不同方案的优缺点,为电源SiP的设计提供参考。
0 引言
随着电子技术的快速发展和终端应用场景更加苛刻,小型化电源的需求越来越迫切。实现小型化的有效方法之一是采用系统级封装(System in Package,SiP)设计。其理念是采用裸芯片,通过多芯片组装,最终形成具有完整电源功能的封装产品。相较基于分立封装器件的电源产品,电源SiP 的基板面积降至10%~20%,在性能、成本等方面也具有优势[1]。
为提高大功率电源SiP 效率,一般将传统开关电源拓扑中的续流二极管同步MOSFET 取代形成如图1 所示的同步开关电源拓扑,2 个MOSFET Q1 和Q2 形成半桥结构。MOSFET 是影响电源效率、热环境等性能的关键器件[2]。因此,半桥MOSFET 的集成方案需要全面论证,以满足SiP 封装尺寸、载流能力、热阻、工艺、组装维修等方面的需求。
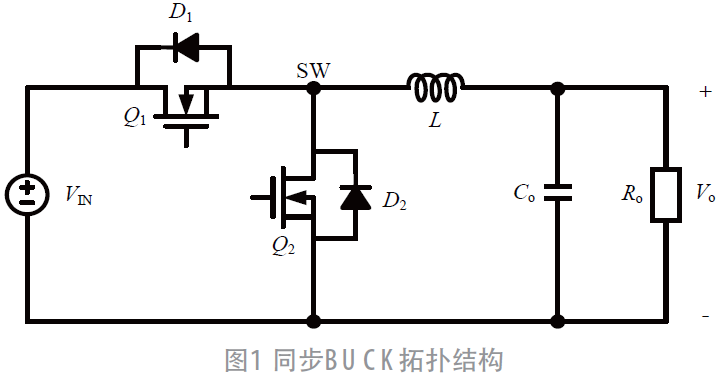
本文讨论了同步开关电源拓扑中的半桥MOSFET的基板表面平铺、腔体设计、3D 堆叠等布局方法,以及键合丝、铜片夹扣等互连方式,通过对比不同方案的优缺点,为电源SiP 方案设计提供参考。
1 MOSFET裸芯片结构
功率开关MOSFET 有3 个端口,即漏极、源极和栅极。一般裸芯片的背面设计为漏极,正面是源极和栅极。源极和漏极的面积大,为大电流路径。正反两面根据实际应用溅射不同金属层。如图1 所示的半桥MOSFET 结构中,上管Q1 的源极与低边的MOSFET Q2的漏极互连在一起。
2 半桥MOSFET布局方法
2.1 基板表面平铺
半桥MOSFET 的平铺布局如图2 所示。为提高电源SiP 的散热性能,降低大电流路径的互连电阻,裸芯片背面的漏极通过锡膏烧焊到基板表面。正面的源极和栅极可通过键合丝或铜片夹扣连接到基板的焊盘上[3]。两芯片的源漏通过基板的铜导带实现互连。由于在基板表面,芯片的组装维修都十分便利。
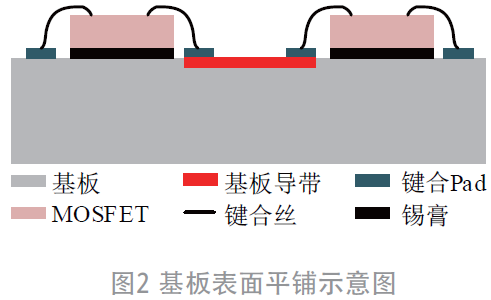
2.2 腔体设计
平铺布局要求基板表面和芯片间有安全距离。为减小封装面积,可以采取如图3 所示的腔体设计,即将基板的外层开放式开窗,将MOSFET 芯片烧焊在内层,基板键合焊盘仍在表面[4]。受电源SiP 空间限制,腔体开窗面积对芯片的组装修改产生一定的影响。腔体设计节省了基板焊盘和芯片间的距离,有利于电源SiP 整体尺寸的减小。
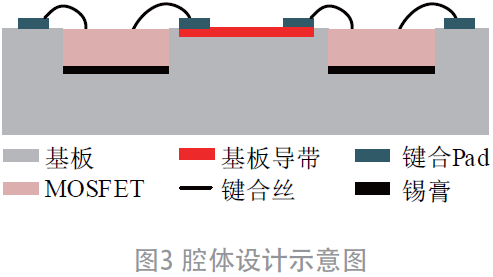
2.3 3D堆叠
如图4 所示,半桥MOSFET 可采用纵向3D 堆叠减小封装面积。两芯片的源极、漏极及与基板导带的互连一般采用铜片夹扣[5]。芯片与铜片间仍通过锡膏烧焊互连。3D 堆叠对组装要求高,芯片焊接偏移需控制严格,避免与栅极键合丝短路;并且芯片维修的便利性差。
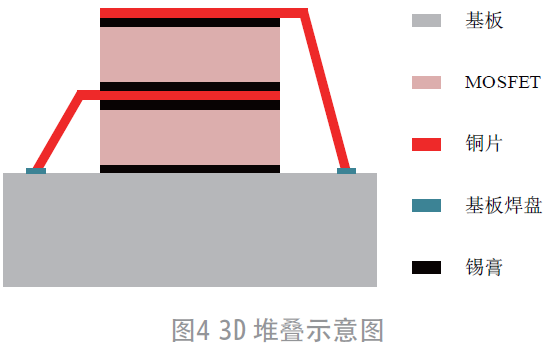
3 互连工艺
3.1 引线键合工艺
引线键合以技术成熟、工艺简单、成本低廉、适用性强等特点而在电子工程互连中占据重要地位[5]。由于铝丝/ 硅铝丝的导电能力强,价格低廉、延展性好,所以常用作MOSFET 的键合引线。
键合丝的材料和丝径影响MOSFET 的过流能力,表1 是常见的键合丝径及其过流能力。

3.2 铜片夹扣工艺
铜片夹扣键合是通过回流焊接的方式,将有特殊形状的铜片焊接于芯片上,实现2 个MOSFET 的源漏极和基板导带的互连。铜片的形状与芯片开窗尺寸和版图设计相关,避免与芯片栅极走线和键合丝短路。MOSFET 芯片表面需要溅射焊锡可浸润的金属材料,如钛镍金等,工艺比较复杂。

*25 A 为32 根45 μm 丝径的硅铝丝并联键合,20 A为8 根100 μm 丝径的铝丝并联键合
4 半桥MOSFET集成方案
在本节讨论中,功率SiP 设计要求输出电流达30 A;尺寸小于15 mm×15 mm,以满足整机对电源小型化的需求。因此,选用的某型号MOSFET 裸芯片,其常温下最大持续漏极电流为95 A,尺寸为4 mm×4 mm。通过讨论不同布局和互连方式的优缺点,确定满足电源SiP 要求的方案。
4.1 基板表面平铺键合方案
基板键合焊盘尺寸设计为4 mm×0.5 mm,满足源极多键合丝并联要求。键合焊盘和芯片烧焊焊盘的安全距离定为0.25 mm。则2 个MOSFET 的总封装面积约为38 mm2。键合丝有两种选择。选择1 是MOSFET 的源极和栅极采用相同的45 μm 丝径的硅铝丝。源极最多能键合32 根硅铝丝并联,由表1 知MOSFET 的安全电流达25 A。选择2 是MOSFET 的栅极和源极分别采用45 μm 丝径的硅铝丝和100 μm 丝径的铝丝。源极最多能键合8 根铝丝并联,安全电流达到20 A。在基板表面平铺方案中,MOSFET 热量主要是通过漏极单面向基板传导。
4.2 基板表面平铺铜片夹扣方案
基板表面平铺铜片夹扣方案如图5 所示。MOSFET源极互连改为0.2 mm 厚度的铜扣,可承受164 A 电流。受MOSFET 的持续漏极电流限制,该方案的半桥MOSFET 的载流能力为95 A。铜扣在基板上的焊盘尺寸设计为4 mm×1.5 mm,则封装面积约为46 mm2。大面积铜片帮助MOSFET 的热量双面向基板传导,极大地降低了芯片的热阻。
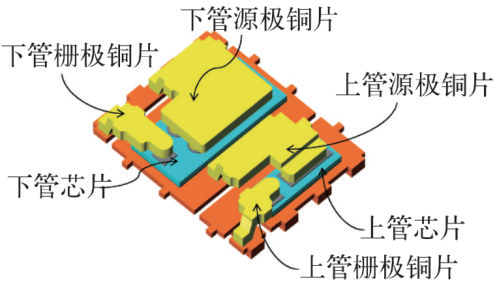
图5 基板表面平铺铜片夹扣方案示意图[5]
4.3 腔体设计键合方案
在腔体设计中,为了组装和维修,开窗面积设计为4 mm×4.2 mm。该方案的键合设计同方案4.1,则需要37.6 mm2 的封装面积,安全电流为25 A(32 根45 μm丝径的硅铝丝并联)或20 A(8 根100 μm 丝径的铝丝并联)。
4.4 腔体设计铜片夹扣方案
该方案的铜扣互连设计同方案4.2,开窗设计同方案4.3,需要45.6 mm2 的封装面积,载流能力为95 A。和方案4.1 和4.2 对比,腔体设计对半桥MOSFET封装面积改善不多。但是可减小MOSFET 芯片与周围器件焊盘的距离,从而减小了电源SiP 整体封装尺寸。由于MOSFET 烧焊在基板内层,相对于基板表面平铺方案,散热性略差,可通过适当增加散热铺铜面积改善热阻。
4.5 3D堆叠铜片夹扣方案
3D 堆叠通过利用纵向空间提高封装效率。若铜扣在基板上的焊盘尺寸同方案4.2,该方案可将半桥MOSFET 的封装面积减小至30 mm2。两片铜扣使芯片双面散热,极大地降低了热阻。
4.6 方案对比
表2 概述了半桥MOSFET 不同集成方案的优缺点。基板表面平铺键合和腔体设计键合方案的工艺复杂度低,组装维修便利性好,但是无法满足电源SiP 输出电流的要求。基板表面铜片夹扣方案在热阻、工艺复杂度和组装维修便利性之间取得了较好的平衡,但是封装尺寸不利于电源SiP 的小型化设计。3D 堆叠铜片夹扣方案具有最小的封装面积和很好的导热性能,但是工艺复杂度高,组装维修便利性低。腔体设计铜片夹扣是相对折中的方案,可以满足电源SiP 设计要求。
5 结束语
本文讨论了半桥MOSFET 不同集成方案。为满足电源SiP 输出电流达30 A,尺寸小于15mm×15 mm 的要求,相对折中的方案是采用腔体设计铜片夹扣方案。该方案的载流能力达到了MOSFET 的最大持续漏极电流95 A;热阻低;因为节省了MOSFET 裸芯片与周围焊盘的距离,有利于电源SiP 的小型化。
参考文献:
[1] 李扬.SiP系统级封装设计仿真技术[J].电子技术应用,2017,43(7):47-50,54.
[2] 陈帅,郗小鹏,张勇.同步BUCK变换器中MOSFET选型应用研究[J].单片机与嵌入式系统应用,2019(11):75-77,81.
[3] 王其超,季睿,姚佳.一种应用于GaN功放的高压电源调制器设计[J].工业控制计算机,2021,34(6):134-135.
[4] 李扬.3D设计技术在SiP中的应用[J].电子技术应用,2018,44(9):39-43.
[5] 霍炎,吴建忠.铜片夹扣键合QFN功率器件封装技术[J].电子与封装,2018,18(7):1-6.
[6] 陈宏仕.MOSFET 器件引线键合技术[J]. 电子与封装,2010,10(7):1-3.
(本文来源于《电子产品世界》杂志2021年12月期)

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码
