Intel Lakefield处理器官方近照:3D 5核心的奥妙
作者:上方文Q
时间:2020-02-13来源:快科技
去年初的CES 2019大展上,Intel正式揭晓了全新的3D Foveros立体封装,首款产品代号Lakefield,已经获得客户和专业机构的认可,被视为Soc处理器未来的新方向之一。
Foveros 3D封装改变了以往将不同IP模块使用同一工艺、放置在同一2D平面上的做法,改为3D立体式堆栈,而且不同IP模块可以灵活选择最适合自己的工艺制程。
近日,半导体产业和分析机构The Linley Group授予Intel Foveros 3D封装技术2019年分析师选择奖之最佳技术奖,并给予极高评价:“这次评奖不仅是对于(Foveros)芯片设计和创新的高度认可,更是我们的分析师相信这会对(芯片)未来设计产生深远影响。”
Lakefield在极小的封装尺寸内取得了性能、能效的优化平衡,并具备最出色的连接性。它的面积仅有12×12毫米,厚度不过1毫米,其中混合式CPU架构融合了10nm工艺的四个Tremont高能效核心、一个Sunny Cove高性能核心,可以智能地在需要时提供最佳办公性能,不需要的时候则可以节能延长续航时间,另外还有22nm工艺基底和其他内存、I/O模块。
迄今为止,Lakefield已经赢得了三款产品设计,一是微软去年10月宣布的双屏设备Surface Neo,二是三星随后推出的Galaxy Book S,三是联想在CES 2020上拿出的ThinkPad X1 Fold。
同时,Intel也放出了Lakefield的最新照片,包括近距离芯面封装图、主板全图:

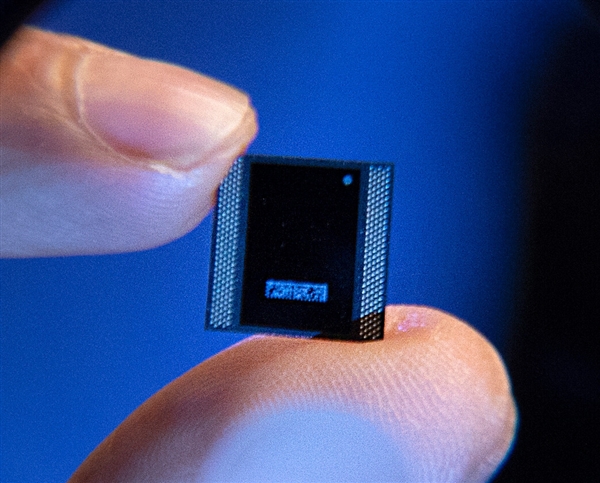




关键词: 英特尔 CPU处理器 LakefieldFoveros

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码