2017年FOWLP封装技术市场急速扩大
日本市场研调机构17 日公布调查报告指出,随着苹果(Apple)于 2016 年在应用处理器(Application Processor,AP)上采用“扇出型晶圆级封装(Fan-out Wafer Level Package,FOWLP)”技术,带动该封装技术市场急速扩大,且预期 2017 年会有更多厂商将采用该技术,预估 2020 年 FOWLP 全球市场规模有望扩大至 1,363 亿日元,将较 2015 年(107 亿日元)暴增约 12 倍(成长 1,174%)。

台湾大厂在FOWLP技术上的布局
目前 FOWLP 的应用主要以移动设备为主,不过只要今后其可靠度提升、Cost down、加上多 pin 化技术有进展的话,预估将可扩大至车用等移动设备以外的用途。富士总研并预估 2020 年全球半导体元件(包含 CPU、DRAM、NAND、泛用 MCU 等 16 品项;不含省电无线元件)市场规模有望较 2015 年(261,470 亿日元)成长 11% 至 289,127 亿日元。
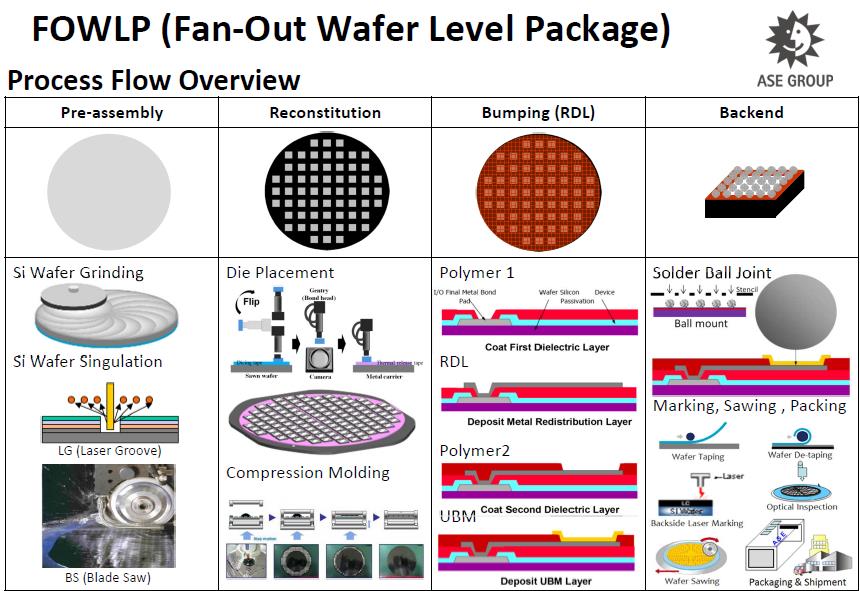
日月光晶圆封测级WLP技术流程
在半导体元件市场上,市场规模最大的产品为 CPU,其次分别为 DRAM、NAND、泛用 MCU。其中,CPU 正饱受服务器虚拟化、智能手机市场成长钝化等因素冲击,且因低价格带智能手机比重上扬、导致 CPU 单价很有可能将走跌,故预估其市场规模可能将在 2019 年以后转为负成长。
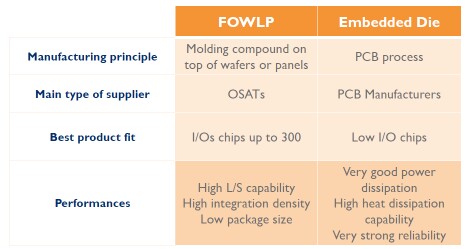
FOWLP与传统嵌入式Die封装技术对比
据预估,2020 年 NAND 全球市场规模有望达 52,740 亿日元,将较 2015 年大增 43.9%;可程序化逻辑阵列 FPGA 预估为 7,550 亿日元,将较 2015 年(4,300 亿日元)大增 75.6%;车用 SoC 预估为 2,563 亿日元,将达 2015 年(1,211 亿日元)的 2.1 倍;次世代内存(包含 FeRAM、MRAM、PRAM(含 3D Xpoint)、ReRAM)预估为 923 亿日元,将达 2015 年(274 亿日元)的 3.4 倍。
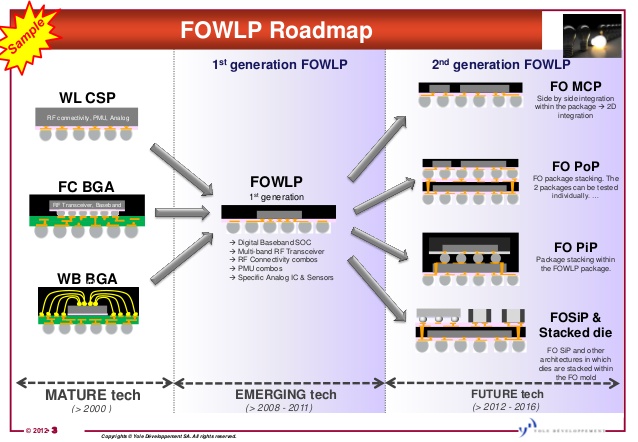
FOWLP技术Roadmap
另外,2020 年做为半导体材料的晶圆(包含硅晶圆、SiC 基板/氧化镓基板、GaN 基板/钻石基板)全球市场规模预估为 9,919 亿日元,将较 2015 年(8,841 亿日元)成长 12.2%。

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码