集成电路芯片热机械应力特征研究
编者按: 摘要:本文在试验和理论两个方面,系统研究了芯片热机械应力特征。作者利用红外热成像技术研究了芯片内部热机械应力随工作电流的瞬态变化关系,发现芯片热机械应力随工作电流呈对数增长。同时本文利用有限元方法模拟计算了芯片热机械应力在不同电流密度下与总工作电流的关系,从而验证了上述实验结论,并发现随着电流密度增加芯片内部热机械应力上升速率变快。 引言 随着集成电路技术的发展,电路元件集成度不断提高,尽管芯片总功耗在降低,由于芯片面积和元件尺寸不断减小,导致芯片的热功耗密度不断增大,芯片内部温度和热机械
摘要:本文在试验和理论两个方面,系统研究了芯片热机械应力特征。作者利用红外热成像技术研究了芯片内部热机械应力随工作电流的瞬态变化关系,发现芯片热机械应力随工作电流呈对数增长。同时本文利用有限元方法模拟计算了芯片热机械应力在不同电流密度下与总工作电流的关系,从而验证了上述实验结论,并发现随着电流密度增加芯片内部热机械应力上升速率变快。
引言
随着集成电路技术的发展,电路元件集成度不断提高,尽管芯片总功耗在降低,由于芯片面积和元件尺寸不断减小,导致芯片的热功耗密度不断增大,芯片内部温度和热机械应力随之变得异常复杂[1]。在正常工作条件下,芯片产生非均匀交变温度场,芯片中元件组成部分间热膨胀系数(Coefficient of Thermal Expansion) 的不同而导致产品内部产生热机械应力及热机械应力不均匀问题,当芯片局域热机械应力达到一定程度会对芯片可靠性造成严重影响。目前研究人员主要关注封装对芯片热应力的影响,王宏伟研究发现基于热力学理论,针对典型塑料方形扁平封装体PQFP在工作过程中的受热失效问题,研究发现非均匀温度场和材料热膨胀系数的不匹配的综合作用,使各层接触的边角处,芯片和粘结层以及芯片和外壳之间存在较大热应力[2];孙炳华利用有限元方法给出了在稳态情况下,CSP结构的热应力分布状况[3];研究发现在芯片工作过程中内部局域热机械应力达到一定值会导致芯片失效[4-5]。对集成电路芯片热机械应力研究相对较少,研究人员利用GDSM方法(Gradient Direction Sensor Method)对大规模集成电路芯片的热机械应力进行了研究,给出了降低芯片局域热峰值的可能措施[6-7]。
本文作者设计了一款芯片模型,在实验上测得了芯片工作电流密度与热机械应力的关系,发现芯片热机械应力随电流密度呈对数增加,在理论上利用有限元方法验证了上述结论。
1 芯片模型及有限元计算描述
为了精确考核芯片热机械应力特征,作者专门设计了一款芯片,示意图如图1(a)所示。芯片中最底下是GaAs基衬底,厚度为100μm,中间是PN结外延层,厚度为3μm。为了最大程度模拟芯片局域热机械应力状况,在最上面设置了五条金属窗口,电路可以通过此窗口加载到芯片上,称之为“热源”,其宽度为10μm,间距为100μm。
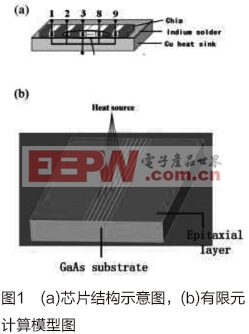
有限元模拟计算模型建立如图1(b)所示,基于三维有限元方法,芯片温度分布通过解热传导方程得到:

热应力应变分布可以根据下面公式由温度分布转换而得到:


加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码