用于检测裸硅圆芯片上少量金属污染物的互补性测量技术
就产品质量和生产环境的清洁度而言,半导体产业是一个要求很高的产业。金属污染对芯片有害,所以应避免裸晶圆芯片上有金属污染。本文的研究目的是交流解决裸硅圆芯片上金属污染问题的经验,介绍如何使用互补性测量方法检测裸硅圆芯片上的少量金属污染物并找出问题根源,解释从多个不同的检测方法中选择适合方法的难度,以及用寿命测量技术检测污染物对热处理的依赖性。
前言
本文旨在解决硅衬底上的污染问题,将讨论三种不同的金属污染。第一个是镍扩散,又称为快速扩散物质[1],它是从晶圆片边缘上的一个污点开始扩散的金属污染。第二个是铬污染,它是从Bulk体区内部扩散到初始氧化膜[2],并在晶圆芯片上形成了一层较厚的氧化物。第三个是晶圆片边缘周围的不锈钢污染。本文的研究目的是根据金属和图1所示的污染特征找到污染的根源。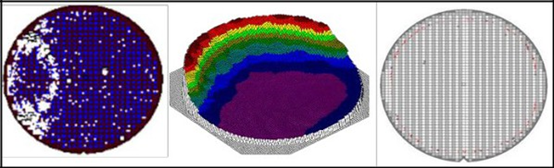
图1 : 三个金属污染范例的映像图。从左至右:镍扩散的微掩膜缺陷图;较厚的铬氧化沉积层;晶圆片边缘上不锈钢污染电子晶圆片检测(EWS)映射图
材料和方法
对于这些范例,我们是将多个不同的测量工具相互配合使用,才发现金属污染物的存在。
全反射X射线荧光(TXRF)分析仪利用角度极小的X射线激励抛光晶圆片表面,以获得表面上的金属污染物含量的映射图[3]。
气相分解电感耦合等离子体质谱仪(VPD-ICPMS)是透过电离使样品离子化,并使用质谱仪分离离子,进行量化分析,以检测含量极低的金属和几种非金属[4]。
表面光电压(SPV)方法是半导体表征测试所用的一种非接触式技术,其原理是分析在表面电压中照明引起的电荷。表面电荷和照明都可以测量表面电压、氧化物厚度、接口陷阱密度、移动电荷、少数载流子扩散长度和产生寿命[5]。
微波检测光电导衰减(μ-PCD)载流子寿命测量法也是一种非接触式方法,在芯片制造过程中,用于晶圆来料检查、质量控制和过程监测。该方法用激光脉冲照射硅氧化层,产生电子空穴对,以此表征载流子复合寿命。使用微波讯号可以监测衰减载流子的浓度瞬变,详见文献[6]。
动态二次离子质谱(DSIMS)可以分析材料从表面到100微米深度或更深的元素组成。该方法使用连续聚焦的一次离子束溅射样品表面,从被溅射脱落的离子化材料中提取部分样品,放到双聚焦质谱仪中,使用静电和磁场根据离子的质荷比分离离子[7]。
KLA 2367检查工具用于扫描缺陷后的特征,显示缺陷程度和映像图,检测尺寸限制在0.16μm以上[8]。该缺陷检测工具目前使用的是裸片对裸片比较方法。
椭偏法用于测量厚度,是一种无损测试方法,主要用于确定Bulk体区材料的光学指针和衬底上沉积或生长的薄层(小于或等于5 nm)的厚度均匀性,详见文献[9]。
最后,光致发光光谱技术是用来表征半导体的光学和电子特性。光致发光(PL)光谱技术是效果很好的研究半导体和半绝缘材料的本征和非本征电子结构的技术,有助于确定杂质含量,识别缺陷复合物,测量半导体的带隙[10]。

图2 : 在RTO处理后的SPV映像 参考文献 [1]S. Dubois and S. Martinuzzi,
“Metal impurities in multicrystalline silicon solar cells: comparison
between fast and slow diffusers” in Conference Record of the IEEE
Photovoltaic Specialists Conference, May 2008. [2]C. J. Hsiao, A. S. Teng, W. C. Chang, Y. Y. Chen, M. Y. Lee, Y. S. Tsai, T. W. Lee, D. J. Lin, A. Dai and C. Y. Lu, “Investigation of Chromium Contamination induced TDDB Degradation in MOSFET” in IPFA 2013, p. 61-64. [3]H. Aiginger, “Historical
development and principles of total reflection X-ray fluorescence
analysis (TXRF)” in Spectrochimica Acta Part B: Atomic Spectroscopy,
1991, Vol. 46, Issue 10, p. 1313-1321. [4]M. Horn, “Applications of ICP-MS in semiconductor industry” in Fresenius J Anal Chem, 1999, 364 : 385–390. [5]Dieter K Schroder, “Surface voltage and surface photovoltage: history, theory and applications” in Measurement Science and Technology, 2001, Vol. 12, num. 3. [6]J. Harkonen, E. Tuovinen, Z. Li,
P. Luukka, E. Verbitskaya, V. Eremin, “Recombination lifetime
characterization and mapping of silicon wafers and detectors using the
microwave photoconductivity decay (μPCD) technique” in Materials Science
in Cemiconductor Processing, 2006, Vol. 9, Issues 1-3, p. 261-265. [7]G. Teeter, “Dynamic Secondary Ion Mass Spectrometry” in Materials Science, NREL Transforming Energy. [8]X. Luan, Y. Liu, B. Zhang, S. Wang, X. Niu, C. Wang, J. Wang, “Investigation of the barrier slurry with better defect performance and facilitating post-CMP cleaning” in Microelectronic Engineering, 2017, Vol 170, p. 21-28. [9]F. Ferrieu, J.H. Lecat,
“Characterization of thin films and materials used in semiconductor
technology by spectroscopic ellipsometry” in Characterisation of Thin Films and Coatings, 1988, Vol 164, p. 43-50. [10]J.E. Toney, “Photoluminescence Spectroscopy” in Characterization of Materials, 2002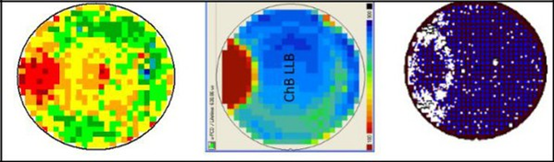
图3 : 镍特性映射图(从左到右)与SPV、μPCD和缺陷检测技术比较
图4 : 测量点的VPD-ICPMS映射图
测量结果与讨论
A.案例1:镍,快速扩散物质
第一个案例是透过缺陷检测设备发现的。在晶圆片有效区蚀刻后,许多晶圆片在左四分之一处出现相同的缺陷特征。这些晶圆片都是来自同一供货商的同一批次产品。
然后,从这批来料裸晶圆片中取出若干样片,透过不同的测量技术进行分析。TXRF、VPD-ICPMS和SPV测量方法均未发现任何缺陷,所有圆片洁净无瑕。
这个缺陷是在圆片有效区蚀刻后才检测到的,因此,我们决定先对样片进行快速热氧化(RTO)处理,加热到1,300 K左右,持续大约一分钟,然后,使用SPV测量方法检测,在晶圆片左侧看到一小块污染区[图2]。
然后,将晶圆片置于熔炉中加热到更高的温度(1,100 K,5个小时)。在SPV和μPCD(条件:1,300 K,2小时)仪器上观察到与缺陷检测设备发现的完全相同的特征 [图 3]。
使用VPD-ICPMS测量方法发现了污染成分。如图4所示,在热处理后,测量晶圆上的六个点:三个在晶圆的右侧(点1、2和3),三个在左侧(点4、5和6)。右侧的三个测量点没有污染,左侧的中心点(点5)的镍含量约18x1010 at /cm2。左侧部分的其他两个位置(点4和6)无法测量,因为,液滴实际上已经丢失,这是晶圆片表面高粗糙度的特征,与造成堆层缺陷的镍污染吻合。
最后,在斜面上进行VPD-ICPMS测量,结果证明,污染物来自晶圆的斜面,而不是边缘。这些最终信息使供货商能够找到晶圆与镍构成的金属物质的接触位置。
这个案例让我们看到,镍在高温下快速扩散,并且相同测量方法在加热前后的测量结果完全不同。此外,它强调了一个事实,即一种测量方法不足以识别问题的根本原因,因此需要多个不同的测量方法配合使用。
案例2:较厚的铬氧化物沉积
这个案例的突出问题是直列初始氧化物厚度范围超出控制范围,高达控制限值的四倍,较厚的氧化物不是同质,但是位于晶圆片区顶部与缺口相对。当用TXRF的扫频模式测量该晶圆片时,在同一晶圆片区域上检测到的是铬污染物,而不是较高的氧化物厚度[图5]。这种在硅氧化过程中发生铬扩散,因杂质而导致氧化层过厚,在文献[2]中有论述。
VPD-ICPMS和TXRF测量证明,铬污染只有在初始氧化后才可以测量到,而来料晶圆上则没有检测到。裸晶圆片的DSIMS配置文件突出了参考晶圆片与不良晶锭上切下的晶圆片之间的差异。在晶圆片背面,可以观察到在整个LTO层(0到300 nm)和多晶硅层(800 nm)上有铬污染,如图6所示,但Bulk体区和正面没有铬污染。
在初始氧化后,观察到从正面表面向下至100 nm深度存在铬,在背面表面和1500 nm深度存在铬[图7]。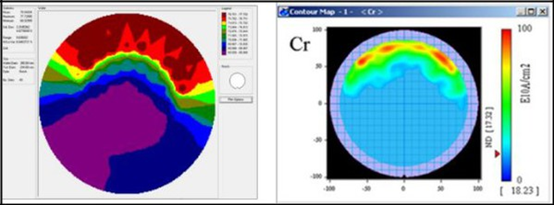
图5 : 从左到右:初始氧化物厚度映射图和铬TXRF映射图。
图6 : 来料受污染晶圆晶背面的DSIMS测量结果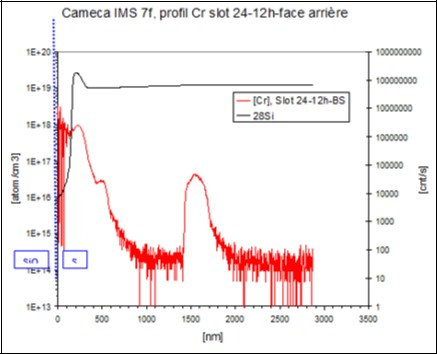
图7 : 初始氧化后受污染晶圆背面的DSIMS测量结果。
在氧化物厚度0.8到1 nm的晶圆芯片上做进一步的VPD-ICPMS和TXRF测量,与0.15 nm厚度参考值对比。在TXRF扫频模式下,受污染晶圆芯片上的平均铬含量在13-15x1010at /cm2之间,而且特征映像图清晰。在五个不同的点进行VPD-ICPMS测量,如图8所示,点1的铬含量最高为88x1010 at/cm2,点2的铬含量为20x1010 at /cm2,点3的含量为5.5x1010at/cm2 和点 4和5低于检测限值,约为0.7x1010 at/cm2。
然后进行了多种不同的测试,以测量在初始氧化熔炉内或在初始氧化物脱氧湿法清洗台内可能发生的交叉污染。在这两个测试过程中,被污染的晶圆片依次放置在两个未污染的晶圆片之间,如图9所示。
测试结果显示,在熔炉中可见交叉污染。在VPD-ICPMS上测量未污染晶圆片,铬含量约为4x1010at /cm2,被污染晶圆片的铬含量约为25x1010 at /cm2。 在湿法清洗台上未观察到交叉污染。
图8 : 测量点的VPD-ICPMS映射图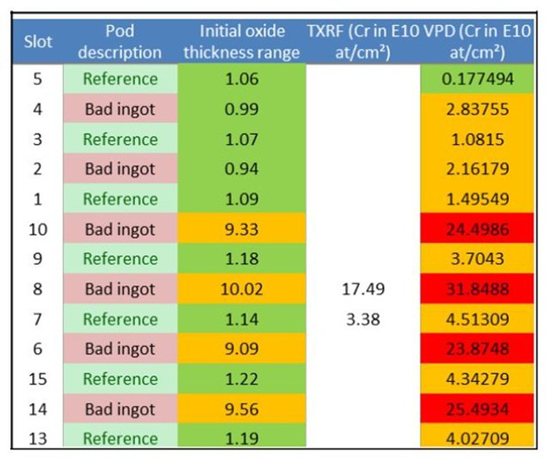
图9 : 初始氧化熔炉内的交叉污染评估
为了验证污染物是否可以去除,先将一些初始氧化晶圆脱氧,然后重新氧化。测试结果良好,铬含量为1.15x1010 at /cm2,参考数值为0.25x1010 at /cm2。
最后,对一些晶圆片进行重新氧化处理,在HV氧化和隧道氧化后,再未检测到任何污染物。因此,铬污染对芯片来说并不是致命的。
所有这些实验使我们能够找到污染的来源。在沉积过程中,大量Cr被掺入LTO中。测试排除了很多假定污染物是因为元器件逐渐老化而从制程腔体或马弗炉排出的情况。这种情况可以使铬扩散到晶圆表面,详见文献[2]。
C.案例3:晶圆片边缘被不锈钢污染
第三个案例是在晶圆电子检测(EWS)期间发现的。 所有晶圆都来自同一供货商的同一晶锭。
检测裸晶圆片的斜面,VPD-ICPMS测试只测到Cu和Al,而在晶圆的有效面上没有测得任何金属物质。经过第一道热处理(快速热处理(RTP))制程后,在裸片有效面上,除大量的铝、钛、铬和铜外,仍然没有测量到任何其他物质。参考晶圆片仅显示有相同含量的铝金属。
在RTP热处理后进行SPV测量,疑似晶圆片的缺陷特征非常清晰,而且在熔炉处理后变得更加清晰[图10]。在DSIMS分析期间,未观察到厚度测量或μPCD测量在RTP后受到任何影响,也未观察到Epi/Si接口中存在金属污染。 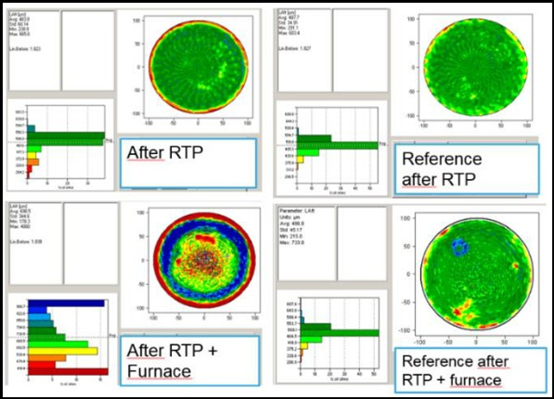
图10 : 在RTP之后(图顶部)和在RTP和熔炉处理后(图底部),受污染的晶圆(左侧)和参考样片(右侧)的SPV映射图。
相反,在RTP和熔炉制程后,用光致发光方法测量裸晶圆片,测试结果良好。在晶圆的左右边缘可见一些缺陷,凹口在底部。在热处理后,在受污染的晶锭上看到了环状特征。在光致发光图与缺陷率映射图迭加后,可以看到,环状特征的直径与缺陷率映射图的直径不完全相同,这可能有多种原因,例如,表面电荷或钝化[图11]。
最终,供货商成功找到了缺陷的根源并重现了问题,原来是上产在线的一颗螺丝错位,刮擦到晶圆片的正面。在受影响的晶圆芯片上进行了五次VPD-ICPMS测量,在五个半径不同圆环上收集污染物。第一次测量是在以晶圆片为中心的0到60公厘半径的圆环上,然后,半径依次是60到70公厘,80到90公厘,最后是90到100公厘(晶圆片的边缘)。在0到90mm圆环上没有测量到污染物。然而,在距边缘最近的圆环上测量到钛、铬、铁、镍、钴、铜和钼,这与缺陷的根源相关。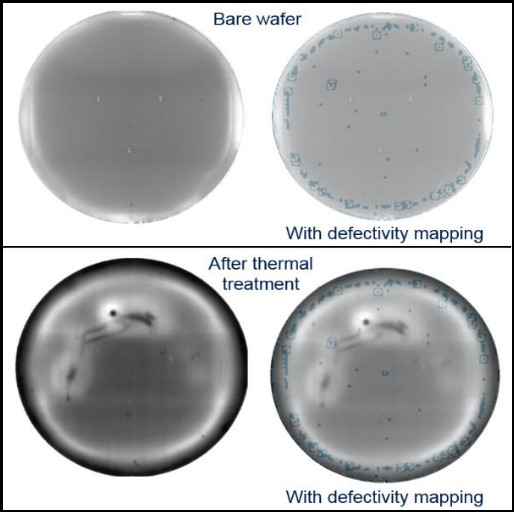
图11 : 受污染的裸晶圆片的光致发光图(左侧)及其与缺陷率图的迭加图(右侧),热处理后的受污染的裸晶圆片的光致发光图(左侧)及其与缺陷率图的迭加图(右侧)。
结论
寿命测试和直接金属污染测量是互补性技术,应配合使用。需要记住的是,在检测和确定金属污染时,没有完美的测量技术,每种情况都是独特的。
这些特定案例证明,为检测一个问题选用不同的技术不是易事,用寿命测试技术检测污染物依赖热处理。实际上,在裸晶圆芯片上,任何SPV、TXRF或VPD-ICPMS方法都无法检测到第一种情况的镍污染和第二种情况的铬污染。仅在对晶圆片进行退火处理后,才发生镍扩散,并且在SPV上可见,并且仅在初始氧化制程后,厚度测量才显示出晶圆芯片上氧化物厚度不均匀。透过TXRF和VPD-ICPMS测量,可以将其表征为铬,并且由于DSIMS分析,才发现其存在于晶圆片Bulk体区内部。
最后,对于第三种情况,在热处理后,晶圆片边缘的环状污染物在SPV测量中变得明显,但只有VPD-ICPMS方法和在晶圆片边缘上收集的特定物质,才让我们得出不锈钢污染的结论。
(本文由意法半导体提供,作者为Lamoureux Violette、Figarols Francois、Pic Nicolas、Vitrani Thomas)

加入微信
获取电子行业最新资讯
搜索微信公众号:EEPW
或用微信扫描左侧二维码

